1提高沉积速度的方法 单纯提高镀液的沉积速度并不需要特殊方法,通过调节基本槽液组成和操作条件,就可以获得较高的沉积速度,下面这些方法很有效:①提高槽液的搅拌速度;②升高槽液温度;③降低游离氰浓度;④减少硼氢化物槽的游离0h-浓度,或增加dmab槽的游离0h-浓度;⑤提高还原剂浓度。但采用上面这些简单方法获得大于2μm/h的沉积速度并没有什么价值,因为这些措施会导致槽液自发分解。因此,一般采用下列方法配制高速镀槽。 (1)加入去极化剂。众所周知,电镀软金槽中加入了少量pb2+或t1+的金电极的去极化剂,也就是说,pb2+或t1+使金的沉积电位向正电位方向移动,这些离子在金上进行所谓的欠电位沉积(upd)。在比平衡电位负的电位下,金上形成了强吸附的金属原子。upd离子的去极化影响可以解释为,upd金属与[au(cn2)]一发生置换反应,使原来的金属离子获得再生,形成吸附的金属原子。因此upd离子对金的还原起催化剂作用:  总反应是: 当upd离子加入硼氢化物或dmab槽中,[au(cn2)]-的还原电位向正电位方向移动,从而加快了沉积速度。 matsuoka等人[19]将pbcl2或tlc1加入到含kauⅲ(cn)4[取代kau(cn)2]的硼氢化物槽中后,发现其沉积速度比不加添加剂时快8~9倍。由于镀槽中的[au(cn)4]一被硼氢化物还原成[au(cn)2]-,因此沉积反应基本与常规硼氢化物槽一致。但由于[au(cn)4]一还原成[au(cn)2]一时产生游离cn-,因而配槽时不需要加入cn-,这也是该体系的优点。表21—2是matsuoka提出的槽液组成,图21—3表明了pb2+对[au(cn)2]-还原的去极化影响,图21—4为pb2+和t1+的加速影响。 表21.2用氯金(ⅱi)酸盐取代氯金(t)酸盐的硼氢化物槽  来源:matsuoka等[l9]。 ![pbcl2对[au(cn)2]-还原极化曲线的影响(matsuoka等[19])](http://www.youjixi.net/file/upload/202107/14/155641971.jpg) 图2t-3pbcl2对[au(cn)2]-还原极化曲线的影响(matsuoka等[19]) ![pbcl2和tlc1浓度对硼氢化物槽沉积速度的影响(matsuoka等[l9])](http://www.youjixi.net/file/upload/202107/14/155641951.jpg) 图21-4pbcl2和tlc1浓度对硼氢化物槽沉积速度的影响(matsuoka等[l9]) (2)加入稳定剂。过去为了提高沉积速度作过一些尝试:加入有机化合物毒化金的催化活性,同时升高槽液温度或提高还原剂浓度以补偿由毒化影响所降低的沉积速度。使用该方法的镀槽在90℃高温下操作,沉积速度[20]可达l2~23gm/h。但是,在如此高的温度下,还原剂的水解会大大加速,从而很难控制槽液组成,因此它不具有实用性。 homma[21]通过加入少量间二甲胺基亚甲基若丹宁(p—dimethylamin0—benzylidenerhodanine)作稳定剂,同时将硼氢化物的浓度增加1倍,成功地将沉积速度提高到5tlm/h;ott[22]发现乙二醇单醚、二乙二醇单醚和聚乙胺这类化合物也可用作稳定剂来提高沉积速度。 (3)用氰金(ⅲ)酸盐取代氰金(工)酸盐。除了前面matsuoka等人提出的氰金(m)酸盐槽外,el一shazly和baker[23]也开发出了用kauⅲ(cn)4作金源的镀槽。不加任何添加剂的情况下,其沉积速度为2~8μm/h。使用au(hi)化合物的突出特点是用kau02或kau(oh)4代替氰化物来补充金,从而避免了游离cn-积累降低沉积速度。au(i)化合物不能稳定存在,因此au(111)镀槽能够在较宽的使用范围内保持恒定沉积速度。 ohtsuka等人[24]详细研究了氰金(1li)酸盐作金源的dmab镀槽,他们发现在70~75℃下,au(ⅲ)化合物很快被硼氢化物直接还原成au(i),因此,可以用kau(cn)2配槽,由au(oh)3溶于稀koh配制的溶液进行补充。 simon[25]描述了利用一种“加速剂”来消除dmab槽中游离cn-积累造成的不利影响,但没有透露加速剂的化学成分。 (4)加入还原剂的阳极氧化加速剂。如果在镀槽中加入一种适当的催化剂来 加速还原剂的阳极氧化,那么该反应的电位将负移,从自催化金属沉积的一般原理来看,还原剂氧化电位的负移将会提高沉积速度。iacovangeloe26]发现碳酸根离子和三乙醇胺可以加速dmab的氧化,但还不清楚加速影响的机理。 2提高槽液稳定性的方法 在所有自动催化体系中,提高沉积速度将导致槽液稳定性下降,除非是通过提高槽液的搅拌速度或基体的移动速度,在传质极限条件下来提高沉积速度。加入21.3.1节中提到的稳定剂可以控制槽液的活性,从而提高槽液的稳定性。另外,应该认识到,进入槽液的某些杂质可能会导致槽液不稳定。在21.1节中已经论及硼氢化物槽和dmab槽对ni2+、c02+、fe2+杂质极为敏感,而cu2+没有什么影响。图21—5示出了对比了ni2-和cu2+对沉积速度的影响,不含杂质时的沉积速度与含不同cu2+浓度的速度一样,具有恒定的沉积速度;槽液中仅含l0-5mol/l的ni2+就会使沉积速度下降,ni2+浓度达到l0-3mol/l时槽液分解;c02+和fe2+的影响与ni2+相似。电化学研究ni2+的影响表明,优先吸附在金表面上的[ni(cn)4]2-大大抑制了还原剂bh30h-的阳极氧化[4]。为了抑制过渡金属所引起的槽液分解,all和christie[27]提出,在槽液中加入edta和乙醇胺,使之与金属形成高稳定络离子,并阻止这些金属与还原剂反应(如表21—3所示)。 ![ni2+和cu2+杂质对硼氢化物槽沉积速度的影响(okiuaka等[5])](http://www.youjixi.net/file/upload/202107/14/155641451.jpg) 图21—5ni2+和cu2+杂质对硼氢化物槽沉积速度的影响(okiuaka等[5]) 应该注意,某些有机物,如聚乙烯[5]也可能导致硼氢化物和dmab槽分解,溶液的储存容器以及配槽所用水都可能含有微量有机杂质。 21.3.3镍基体上化学镀金 基于上述原因,硼氢化物或dmab槽都不适合于镍金属基体上直接镀金,普遍采用的方法是将镍基体在化学镀金前浸(置换镀)一层薄金,但由于镍基体上完全覆盖浸金层很困难,而槽液对溶解的少量镍离子极为敏感,因此,上述方法不能完全满意地解决镍杂质的问题。 近,iacovangelo[26]提出了一种镍上化学镀金新方法,该方法不用置换金,使用的镀槽含两种还原剂,即dmab和肼,表21—4给出了槽液组成。醋酸铅和碳酸钾分别对阴极部分反应和阳极部分反应起加速作用,从而提高了沉积速度。金属镍基体浸入镀槽时,借助于镍上肼的催化氧化,金开始产生沉积,au(工)还原成au。当镍基体完全被金覆盖后,dmab成为单一还原剂通过自催化机理在金上继续沉积金,选择适当的槽液组成可以消除置换镀所产生的镍溶解。iacovangl0研究了镍和金上肼及dmab氧化的阳极极化曲线,从电位范围可以看出,肼是在镍上氧化而不是在金上(如图21—6所示),而dmab在金上的氧化速度比镍上快近100倍(如图21—7所示)。该槽巧妙地利用镍和金对两种还原剂氧化的催化活性差异,当要求基体金属不与槽液发生置换反应时,该原理很实用。 表21-3含edta和乙醇胺的硼氢化物槽 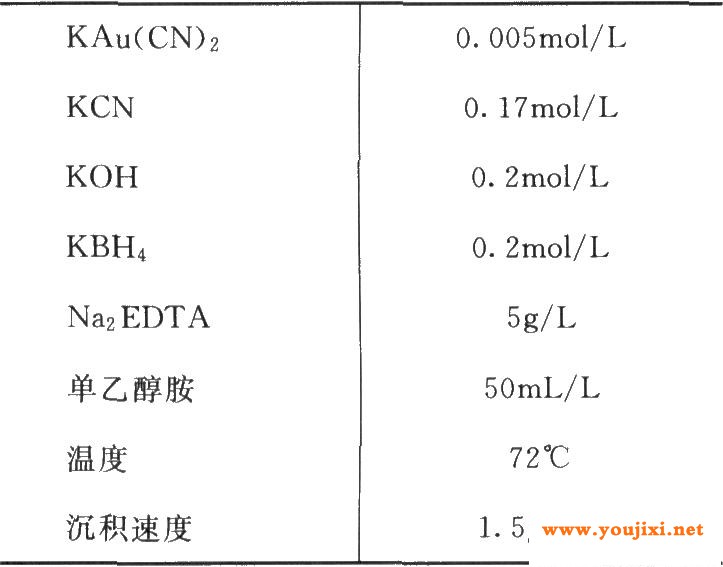 来源:aliandchrigtie[27]。 表21-4双还原剂(dmab和肼)化学镀金槽 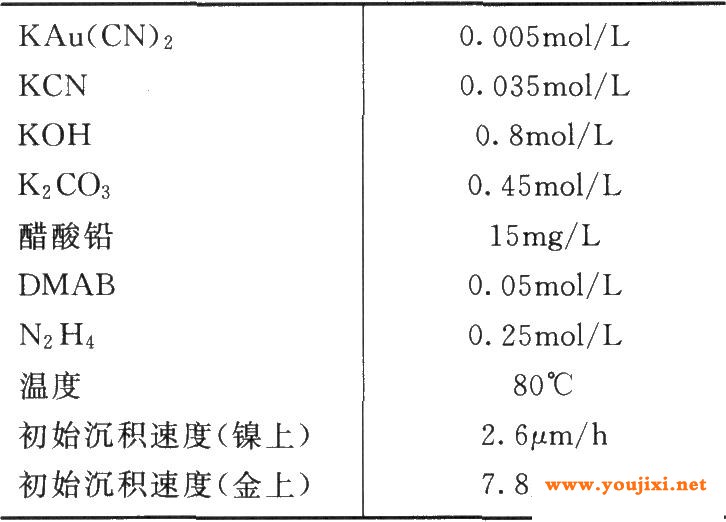 来源:iacovangelo[26]。 ![镍电极上[au(cn)2]-还原和肼氧化的极化曲线](http://www.youjixi.net/file/upload/202107/14/155641551.jpg) 图21—6镍电极上[au(cn)2]-还原和肼氧化的极化曲线 溶液:0.8mol/lkoh、0.035mol/lkcn、0.05mol/ln2h4,80℃(iacovangelotml) ![镍和金电极上[au(cn)2]-还原及dmab氧化的极化曲线(iacovangelo[20])](http://www.youjixi.net/file/upload/202107/14/155641401.jpg) 图21—7镍和金电极上[au(cn)2]-还原及dmab氧化的极化曲线(iacovangelo[20]) iacovangel0和zarnoch[28]开发了用肼作还原剂在镀金的镍基体上催化沉积工艺,可以获得用于连接电子元件的厚金层。利用基体催化反应获得的大镀层厚度取决于槽液中游离cn-浓度(如图21—8所示),而不是常规自动催化镀工艺所依赖的沉积时间。 ![不同氰化物浓度下,肼作还原剂的基体催化镀金层厚度与时间的关系曲线(iacovangelo[28])](http://www.youjixi.net/file/upload/202107/14/155641951.jpg) 图21—8不同氰化物浓度下,肼作还原剂的基体催化镀金层厚度与时间的关系曲线(iacovangelo[28]) 相关阅读:化学镀金:硼氢化物和dmab槽的特性 化学镀金:其他还原剂的氰化物镀槽 化学镀金:无氰镀槽 |












